该论文主要研究了在集成电路(IC)封装中,使用镀钯铜线(Pd-coated Cu wire)和银合金线(Ag alloy wire)作为传统金线(Au wire)替代品的可行性。鉴于金价在过去十年中大幅上涨(是十年前的5倍以上),寻找低成本的键合线替代材料具有重要意义。研究重点关注这两种替代线材在存储器件上的键合能力和可靠性表现,因为存储器件的铝(Al)焊盘通常较薄,对键合工艺更为敏感。

●金线(Au)的挑战: 尽管金线因其高导电率和优异的可焊性长期用于存储器件,但其高昂的成本促使业界寻求替代方案。
●铜线(Cu)作为替代: 铜线是降低引线成本的普遍选择,但其较高的硬度限制了其在某些应用中的使用,尤其可能导致焊盘损伤。
●银线(Ag)作为替代:
○优势: 银线的硬度与金线更为相似,有利于减少焊盘损伤。同时,银的价格远低于金。
○挑战: 纯银线在与铝焊盘结合时,其Ag-Al界面腐蚀问题对可靠性构成严重威胁。
○解决方案: 通过开发合金化银线技术(如添加钯Pd等元素)来提高其可靠性性能,使其成为金线的另一潜在替代品,特别适用于易碎的焊盘结构。
本文旨在比较镀钯铜线和(经过成分调整的)银合金线的性能。


●目标器件: 选择一种存储器件进行实验,其封装结构如图3所示(包含器件Device、固晶胶膜DAF、PCB板和焊球Solder Ball)。
●测试引线:
○镀钯铜线 (Pd-coated Cu wire)
○银合金线 (Ag alloy wire)
○两种线的直径均为23µm。
●键合保护气体: 氮气 (N2)。
●键合能力评估:
○比较参数窗口(可接受的键合工艺参数范围)。
○焊球形状。
○铝溅出情况 (Al splash)。
○拉力测试(球焊点拉力BPT和第二焊点拉力,如图4所示)。
○焊盘裂缝 (Pad cratering)。
○电性测试良率。
●可靠性评估:
○uHAST: 非偏置高加速温湿度应力测试 (Unbiased Highly Accelerated Temperature/Humidity Stress Test),条件为 130°C, 85%RH。
○HTS: 高温存储测试 (High Temperature Storage),条件为 150°C。
○TC: 温度循环测试 (Temperature Cycling),条件为 -55°C ~ +125°C。
●失效分析技术:
○聚焦离子束 (FIB)。
○透射电子显微镜 (TEM)。
○能量色散X射线光谱 (EDS)。
○主要用于检查Ag-Al界面和金属间化合物 (IMC) 的特性。
●银合金线成分调整:
○根据初步可靠性测试的失效情况,调整了银合金线中的钯 (Pd) 含量,分为A型(低Pd)、B型(中Pd)和C型(高Pd)进行研究。
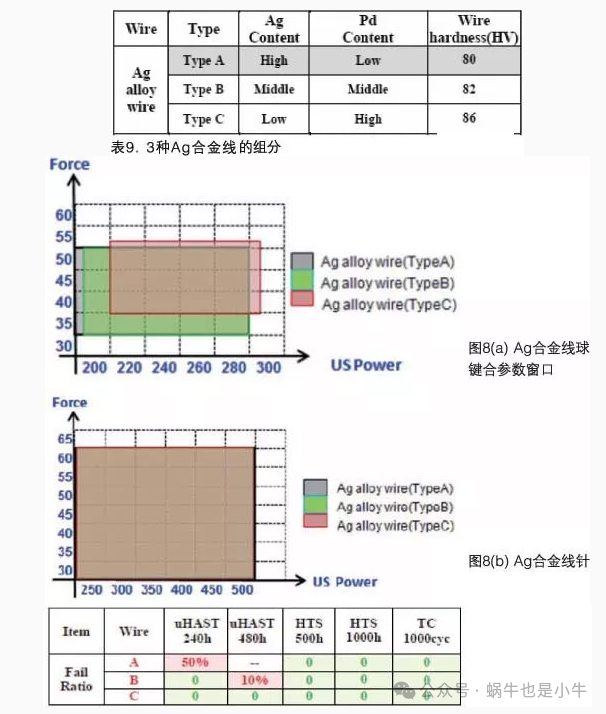

●结论: Cu线的FAB硬度最高,比4N金线高约50%。Ag合金线的FAB硬度仅比4N金线高约10%。这预示着Ag合金线在减少焊盘损伤方面可能更有优势。
●键合参数 (图5): Cu线需要显著更高的超声功率 (US Power) 和键合力 (Force)。Ag合金线的可接受参数窗口更大。
●焊球拉力测试 (BPT, 表2): Cu线的BPT值(平均8.6gf)高于Ag合金线(平均7.9gf),主要因为Cu线本身具有更高的断裂负载。两种线的断裂模式均为引线断裂 (Wire break)。
●焊球形状及Al溅出 (表3): 参数优化后,两种线的焊球形状均可控。但Cu线的Al溅出远大于Ag合金线,这可能导致短路风险。
●焊盘损伤 (KOH腐蚀后观察, 表4):
○Ag合金线: 在整个键合参数窗口内,焊盘表面光滑完整。
○镀Pd Cu线: 观测到焊盘凹坑/弧坑 (Pad Cratering) 问题。
●键合参数 (图6): Cu线同样需要更高的超声功率和键合力。Ag合金线的参数窗口也更大。
●第二焊点形状和拉力测试 (表5): 两种线的第二焊点形状和拉力测试后的残留物均可控。Cu线的第二焊点拉力值(平均9.42gf)高于Ag合金线(平均7.17gf),同样是因为Cu线较高的断裂负载。

●失效分析 (表7): 对镀Pd Cu线漏电失效的样品进行分析,在失效引脚处发现了焊盘弧坑。
●小结: 对于所测试的存储器件,Ag合金线的键合性能明显优于镀Pd Cu线,表现为更低的FAB硬度、更小的键合参数需求、更宽的工艺窗口以及无焊盘损伤。

由于镀Pd Cu线在电测中已出现漏电问题,可靠性测试仅针对Ag合金线进行。
●可靠性测试结果 (表8 - A型Ag合金线):
○uHAST (130°C, 85%RH, 240小时): 约50%的芯片出现电气失效。
○HTS (150°C, 500小时): 通过。
○TC (-55°C~125°C, 1000循环): 通过。
●uHAST失效分析 (图7):
○FIB和TEM分析显示,失效焊球的Ag-Al界面处存在不连续、不平坦的IMC。
○在IMC和Ag焊球之间的界面处(区域5)观察到连续裂缝,并在IMC内部(区域4)观察到明显空洞。这些被认为是导致电性能退化的直接原因。
○EDS分析显示,区域3主要成分为铝和氧(推测为氧化铝),区域2为Ag晶粒。未检测到银的氧化。
○失效机理推断: 高温高湿老化试验中Ag-Al键合的退化是由Ag-Al IMC的腐蚀和裂缝引起的。这种腐蚀被归因于铝的氧化,即Ag-Al之间的电偶腐蚀(由于Ag和Al之间存在较大的静电电位差,在湿气环境下发生)。在此过程中,Ag不能被氧化,而是以Ag晶粒的形式析出。
为解决uHAST测试中的Ag-Al界面退化问题,研究了不同Pd含量的Ag合金线(A型:低Pd;B型:中Pd;C型:高Pd)。
●引线特性 (表9):
○随着Pd含量的增加,引线硬度略有增加(A型: 80HV, B型: 82HV, C型: 86HV),但变化率控制在8%以内。
○B型和C型线的球焊点和第二焊点键合参数窗口与A型相似 (图8a, 图8b),且均未检测到焊盘损伤问题。
●改进后的可靠性结果 (表10):

●C型线uHAST 480小时后界面分析 (图9): SEM检查显示,所有IMC均连续而平滑,未发现明显的裂缝或空洞,特别是在IMC与Ag焊球间的界面上。
●性能提升机理: 实验和分析表明,增加Ag合金线中的Pd含量能够抑制Ag-Al界面上的扩散。较低的扩散速率能抑制它们之间的电偶腐蚀,从而保护Ag-Al IMC的完整性,延长Ag-Al键合系统在可靠性测试中的寿命。
1.镀Pd Cu线: 由于存在无法避免的焊盘弧坑问题,并由此导致电测试中的漏电失效,因此不适用于本研究所用的存储器件的Al焊盘。
2.Ag合金线:
○表现出良好的键合性能,包括键合后界面完整、所需超声功率和键合力较小、以及拥有较大的工艺参数窗口。
○初始的A型Ag合金线在uHAST测试中暴露出Ag-Al界面IMC氧化和裂缝的问题,其根源被认为是Ag-Al电偶腐蚀。
○通过增加Ag合金线中的Pd含量(如C型线),可以有效抑制界面腐蚀,显著提高其在uHAST(通过480小时)和HTS(通过1000小时)测试中的可靠性。
3.建议: 基于本研究结果,Ag合金线(特别是优化Pd含量后)被认为是用于存储器件Al焊盘上的一种有前景的低成本引线替代方案,优于镀Pd Cu线。
该研究为IC封装中寻求金线替代品提供了有价值的实验数据和分析,特别强调了通过合金化手段(如添加Pd)改善银线可靠性的有效性。